-
My ToshibaSemicon
- セミコンダクタートップ
-
アプリケーション車載
ボディエレクトロニクス
xEV
インフォテインメント
産業用機器業務用機器
民生/個人用機器 -
製品車載用デバイス
ディスクリート半導体
ダイオード
トランジスター
汎用ロジックIC
アナログデバイス
※
: 製品一覧(パラメトリックサーチ)
パワー半導体※
: 製品一覧(パラメトリックサーチ)
アイソレーター/ソリッドステートリレー(SSR)フォトカプラー
デジタルアイソレーター
ソリッドステートリレー (SSR)
光伝送モジュール
※
: 製品一覧(パラメトリックサーチ)
MOSFETIGBT/IEGTバイポーラートランジスター※
: 製品一覧(パラメトリックサーチ)
ダイオード※
: 製品一覧(パラメトリックサーチ)
マイクロコントローラーモータードライバーインテリジェントパワーIC※
: 製品一覧(パラメトリックサーチ)
パワーマネージメントICリニアーIC※
: 製品一覧(パラメトリックサーチ)
汎用ロジックICリニアーイメージセンサーその他専用ICその他専用IC
※
: 製品一覧(パラメトリックサーチ)
-
開発/設計支援
-
知る/学ぶ
- ご購入
- 品番・キーワード検索
- クロスリファレンス検索
- パラメトリック検索
- オンラインディストリビューター在庫検索
本機能は Internet Explorer 11 ではご利用頂けません。最新のGoogle Chrome, Microsoft Edge, Mozilla Firefox, Safariにてご利用ください。
品番は3文字以上指定して下さい。 複数品番の検索はこちら。
クロスリファレンスでは参考品名が表示されますので、製品に関する最新の情報をデータシート等でご確認の上、単独およびシステム全体で十分に評価し、お客様の責任において適用可否を判断してください。参考にしている情報は、取得した時点の各メーカーの公式情報に基づいた当社の推定によるものです。当社は、情報の正確性、完全性に関して一切の保証をいたしません。また、情報は予告なく変更されることがあります。
品番は3文字以上指定して下さい。
オンラインディストリビューターが保有する東芝製品の在庫照会および購入が行えるサービスです。
スイッチング電源の効率向上に最適なU-MOS X-Hシリーズ150V耐圧MOSFET
通信基地局用電源やデータサーバー用電源など高効率化が求められるスイッチング電源のため、オン抵抗、電荷容量特性を飛躍的に向上させたU-MOS X-H 150VプロセスのパワーMOSFET (金属酸化膜半導体型電界効果トランジスター) を開発しました。電源の高効率化、小型化、コストダウンによる付加価値の向上に貢献します。
増加する150V MOSFETの応用例

動画ストリーミング等の大容量で通信スピードが要求されるコンテンツが増加し、それに対応した5G (第5世代移動通信システム) サービスの開始等もあいまって基地局、データサーバーの消費電力が飛躍的に増え、使用されるスイッチング電源の高効率化が求められています。
基地局では、AC (交流) -DC (直流) コンバーターによって商用交流電圧から通信用電源電圧の-48Vが、次にDC-DCコンバーターによって-48Vから高周波アンプやシステムコントロールに必要な電源電圧が生成されます。
また、大容量化が進むデータサーバーでも、配線による損失を低減するために48V電源が使用されるケースが増えています。
高性能なMOSFETはこれら通信基地局、データサーバーなどの高効率化が求められるスイッチング電源には必要不可欠であり、素子性能向上の重要度が日増しに高まっています。
U-MOS X-Hシリーズ150V耐圧MOSFETの特長
- 素子構造の見直しとプロセス技術の改善による微細化で、オン抵抗と電荷量特性のトレードオフを改善
- ライフタイム制御技術を適用したハイスピード・ダイオード (HSD) 品により、逆回復時の損失、スパイク電圧を低減
- 高いチャネル温度定格により高温動作に対応 (Tch=175°C)
- アプリケーションノート、リファレンスデザインなど設計省力化に有効な資料をwebで公開
電源の高効率化には、デバイスのオン状態における導通損失と、オン/オフ切り替え時のスイッチング損失の低減が必要になります。MOSFETでは、オン抵抗 (RDS(ON))、ゲートスイッチ電荷量 (Qsw)、出力電荷量 (Qoss)、逆回復電荷量 (Qrr) といった特性の向上が不可欠です。
一般的に、RDS(ON) を改善するためにはセルピッチの微細化が行われますが、微細化だけではQg、Qoss、Qrrも増加してしまいます。そのため、性能指標としてのオン抵抗・ゲートスイッチ電荷量 (RDS(ON)・Qsw)、オン抵抗・出力電荷量 (RDS(ON)・Qoss)、オン抵抗・逆回復電荷量 (RDS (ON)・Qrr) の低減も必要になります。
150V系U-MOS X-Hシリーズは、従来世代の構造を基に、導通時とスイッチング時の両方の電力損失低減を狙い、素子構造の見直しとプロセス技術の改善による微細化で、RDS(ON)を38%、Ron・Qswを12%、Ron・Qossを20%、Ron・Qrrを57%*低減しました。(*標準品 (STD) 品の場合、従来世代U-MOSⅧ-H比)
さらに、逆回復時の損失、スパイク電圧低減のため、ライフタイム制御技術を適用したハイスピード・ダイオード (HSD) 品もラインアップに加えました。HSD品では、Ron・QrrについてSTD品比でさらに74%低減しています。
また、U-MOS X-Hでは175°Cまでの高温動作に対応しています。(従来世代U-MOSⅧ-Hは150°Cまで)
これにより、電源の高効率化、小型化、コストダウンによる付加価値の向上に貢献します。
オン抵抗 (RDS(ON))
U-MOS X-Hシリーズ150Vでは、最新の微細化技術を用いることで従来のU-MOSⅧ-Hシリーズ150Vに対し38%ものオン抵抗低減を実現しました。これにより導通損失を低減し、効率の向上を図る事ができ、並列員数の削減、実装面積の削減によるコストダウン、電源の小型化が可能になります。

出力電荷量 (Qoss)
スイッチング回路では、ターン・オフする毎に出力容量 (Coss) に充電され、充電された電荷 (Qoss) は活用されることなく排出され損失となります。これはスイッチング損失の一部となります。U-MOS X-Hシリーズ150Vでは、同じオン抵抗で比較した場合、U-MOSⅧ-Hシリーズに対しQossを20%低減しています。

逆回復電荷量 (Qrr)
同期整流回路では、内蔵ダイオードの順方向に電流が流れている状態から、急峻にバイアス方向が反転する動作が生じます。このとき、n-型半導体に蓄積されたキャリアー (正孔・電子) が排出又は再結合により消滅するまでの時間 (trr:逆回復時間) に、内蔵ダイオードに対して逆方向の電流 (IDR) を流し続けます。この電荷量 (Qrr) による損失を、逆回復損失と呼びます。

U-MOS X-Hシリーズ150Vでは、同じオン抵抗で比較した場合、U-MOSⅧ-Hシリーズ150Vに対しQrrを57%削減しています。しかしながら低いオン抵抗が必要とされる用途において、より低いオン抵抗の製品を用いたり、あるいは並列に使用する場合はQrrによる逆回復損失が導通損失に比べ相対的に大きくなってしまいます。そこでQrrをさらに削減するため、キャリアの移動を再結合により抑制するキャリアトラップを導入したハイスピード・ダイオード (HSD) 品を並行してラインアップしました。このプロセスを導入していないものをスタンダード (STD) 品として、逆回復動作時の挙動の違いを図に示します。このU-MOS X-HシリーズHSD品は同じオン抵抗で比較した場合、QrrをU-MOS X-HシリーズSTDに対し74%、U-MOSⅧ-Hシリーズに対し89%削減しました。
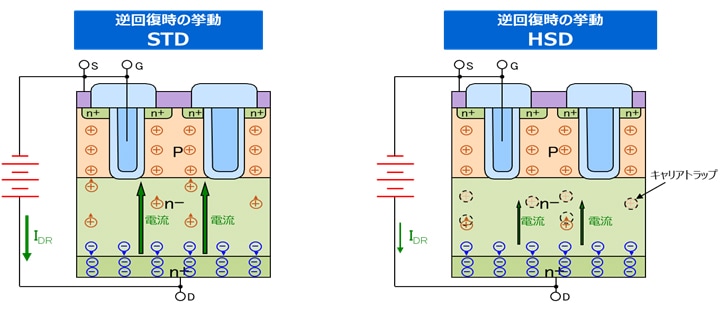

U-MOS X-Hシリーズ150V耐圧MOSFETの製品一覧は以下ページをご覧ください
関連リンク
150V耐圧MOSFETを使用したリファレンスデザイン情報は以下ページをご覧ください
通信機器用非絶縁昇降圧1kW DC-DCコンバーター
MOSFET応用3相マルチレベルインバーター
1kWフルブリッジ方式DC-DCコンバーター
150V耐圧MOSFETを使用したアプリケーション情報は以下ページをご覧ください
サーバー
汎用インバーター/サーボ
電源回路シミュレーションや、PSpice®、LTspice®などのシミュレーション用電気モデルの情報は以下ページをご覧ください
高精度SPICEモデルに関する説明
デバイスモデル (SPICEモデル) のグレード表記に関する説明 (2.5MB)
スイッチング電源回路ライブラリー
オンライン回路シミュレーター



